 SiC领域激光加工行业解决方案
SiC领域激光加工行业解决方案
华工半导体是行业领先的SiC领域激光装备解决方案专家,深耕第三代半导体碳化硅赛道,破解高端装备“卡脖子”核心难题,构建起覆盖SiC衬底缺陷检测、激光标刻、欧姆接触退火、开槽切割、裂片全关键工序的完整产品矩阵,贯通SiC器件制造全流程。
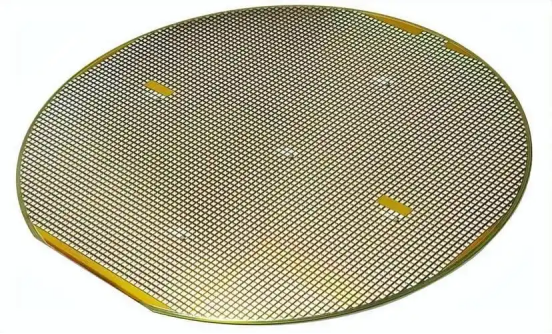
 光电芯片行业解决方案
光电芯片行业解决方案
半导体光电芯片是实现光电信号转换、光信号处理的核心器件,涵盖光发射接收/调制/转换等功能,广泛应用于光通信、激光雷达、硅光集成等领域。材料主要以硅基、磷化铟(InP)、砷化镓(GaAs)、氮化镓(GaN)、铌酸锂(LiNbO3)等多元半导体材料为主,品类繁杂、材质特性差异悬殊,且多采用异质集成的精密复杂结构,对晶圆精密激光加工、尤其是高精度无损标刻提出严苛要求,是光电芯片精密制造环节的核心关键。
华工半导体深耕光电芯片半导体制造赛道,作为半导体全代系材料激光标刻解决方案专家,针对各类光电芯片材质特性开展深度激光工艺研究,实现全材料体系的激光标刻与精密加工全覆盖,凭借极致的标刻精度、材料适配性与加工稳定性,为光电芯片客户提供定制化激光加工解决方案,助力产业提质增效、实现高质量量产。
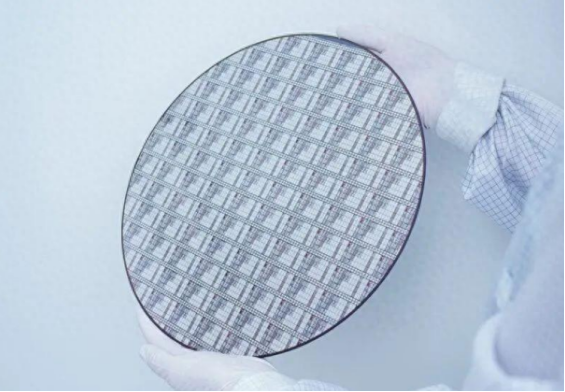
 硅晶圆激光加工智能装备解决方案
硅晶圆激光加工智能装备解决方案
本方案面向半导体硅晶圆制造与先进封装全流程,提供标刻、开槽、改质切割一体化激光精密加工智能装备。以非接触冷加工、高精度视觉定位、智能运动控制与洁净制程为核心,满足6-12inch硅晶圆、超薄晶圆、Low-K晶圆、背金晶圆的量产级加工需求,显著提升良率、降低崩边与分层风险,实现晶圆全生命周期追溯与高效分离,为功率器件、MEMS、传感器、存储与逻辑芯片提供稳定可靠的国产化高端装备支撑。
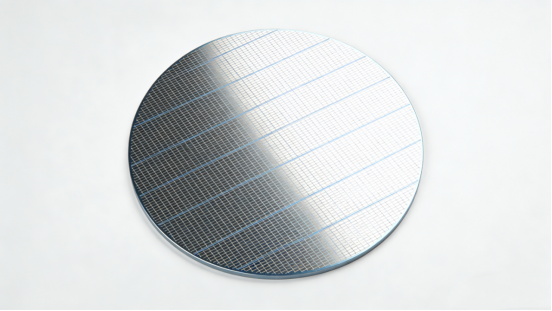
 芯片级激光加工智能装备解决方案
芯片级激光加工智能装备解决方案
芯片级激光加工智能装备解决方案,以超快激光+高精度运动平台+AI视觉+智能工艺库为核心,覆盖开封、开槽、修复、打孔四大核心制程,实现非接触、无应力、微米至亚微米级精密加工,全面支撑先进半导体研发与量产,助力客户提升良率、降低成本、加速产品落地。

 探针卡精密制造行业解决方案
探针卡精密制造行业解决方案
专注探针卡精密制造全流程解决方案,提供探针高精度切割、自动化植入、激光微焊接、针痕AOI检测一体化智能装备。以微米级精度、稳定制程与智能视觉质控,助力高端探针卡高效量产,提升产品一致性与测试可靠性。