碳化硅扩产浪潮下,
晶圆切割成为提效降本关键战场
随着新能源汽车、光伏储能等产业对高性能功率器件需求激增,碳化硅晶圆产能持续扩张。
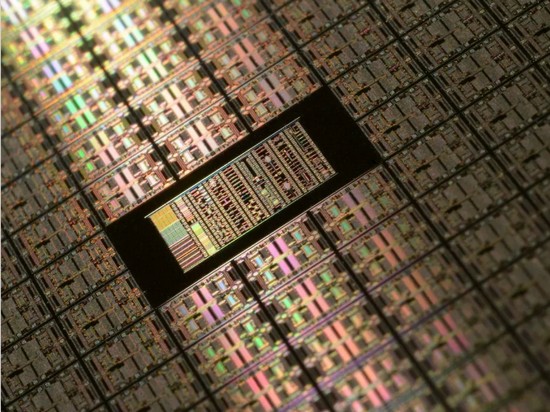
碳化硅晶圆制造完成后,需经过切割与分片工序,将整片晶圆分离成单个芯片,以便进入后续封装测试流程。为了形成高性能的欧姆接触,碳化硅晶圆需要在背面镀金;同时背金也能够满足其作为漏极(Drain)在高温、大功率、高频率环境下稳定运行的需求。因此,切割、分片过程必须同时切断背金层与碳化硅基底,实现芯片的完整分离。
背金层与碳化硅材料硬度差异大,切割工艺控制难度高。如何实现高效、高精度、低损伤的晶圆分割,已成为行业规模化量产的核心痛点。
刀轮加工超薄晶圆受阻
开槽质量直接决定芯片性能与终程良率
碳化硅晶圆传统分片工艺是利用金刚石刀轮切割,存在加工效率低、耗材(纯水、刀具)使用量大、材料损耗高等明显局限。尤其在背金去除过程中,由于金属具备延展性,切割时易面临切削速度受限和金属卷曲问题,严重影响生产效率与切割质量。
先进激光加工技术作为非接触式加工工艺,其原理是通过高能激光束将材料表面加热至熔化和汽化状态,从而在材料表面开出精细的槽纹,无需耗材即可实现对背金和碳化硅基底的高质量加工,为后续工序提供优良基础。

随着半导体器件向小型化、轻薄化发展,超薄晶圆加工已成为行业必然趋势,传统刀轮工艺面临挑战进一步加剧。凭借精度高、效率高、加工质量好等显著优势,激光技术在碳化硅晶圆背金去除和开槽领域的应用日渐广泛。
华工激光助力碳化硅量产
赋能"高效率+高良率"双引擎动力
聚焦碳化硅背金去除痛点,华工激光深化产学研用融合,凭借强大的研发与实施能力,全新升级激光烧蚀技术(Laser Ablation),结合多光束加工技术(Laser Multi-Beam Processing),针对激光开槽表切领域加工需求,打造HGrooving系列激光加工装备,实现工艺突破性升级。
全自动晶圆表切设备
HGrooving系列-LUD3220

多光点加工技术 Laser Multi-Beam Processing
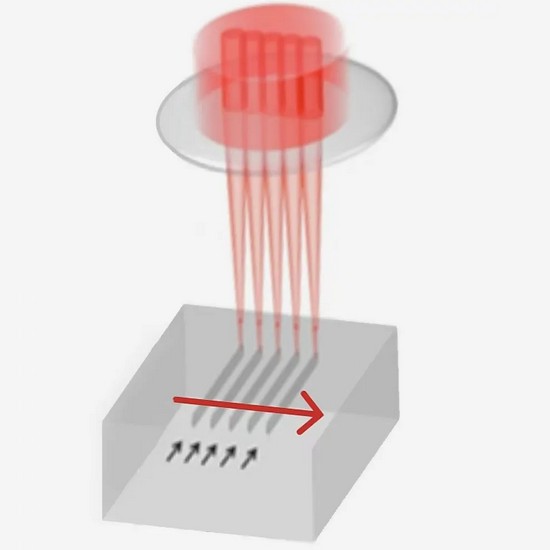
多光点能量匀化输出,
热影响区≤10μm
槽深波动≤0.5μm
边切边修,减少熔边、飞溅,
回熔率低、均一性高
核心亮点
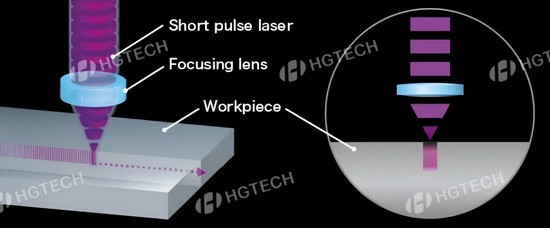
激光开槽表切
权威行业标准
通过半导体SEMI行业认证
兼容6-8英寸晶圆激光正切、背切

晶圆切割效果
自研智能系统
实现残片/破片晶圆自动定位加工
集成多功能单元,生产智能自动化

微观开槽效果
环保高效设计
全新优化高效涂胶清洗机构
耗材用量降低30%

微观开槽效果
该设备从推出至今经历四次技术迭代,结合华工激光自研高性能激光隐切智能装备,可将SiC晶圆切割良率直接提升到99.5%,较行业水平显著提升。
目前该套切割方案在碳化硅晶圆领域已实现批量出货,并得到行业广泛认可和客户高度好评,证明华工激光在化合物半导体加工领域已经具备过硬的技术研发能力和成熟的批量交付能力。
作为碳化硅领域先进激光加工行业解决方案专家,华工激光着力构建覆盖第一代至第四代半导体材料的工艺装备体系,已形成覆盖量测、标记、退火、开槽/表切、隐切、裂片晶圆加工关键制程的全套加工解决方案,贯通半导体前道制造与后道封装环节,针对性为行业客户定制一站式系统解决方案。
未来,华工激光将持续创新,致力为全球半导体产业提供中国技术驱动的核心装备支撑,成为化合物半导体激光及量测装备领导品牌。
演讲预告
9月10日,SEMI-e深圳国际半导体展暨2025集成电路产业创新展(简称SEMI-e)将在深圳国际会展中心(宝安)盛大举行,同期举办第三代半导体设备与核心零部件产业链合作发展论坛,华工激光行业总监肖冲先生参会做专题演讲,为第三代化合物半导体行业介绍先进激光加工技术,带来欧姆接触退火、开槽、切割等关键制程的首选解决方案,实现良率与产能跃升,助力行业升级发展!

参会论坛:
第三代半导体设备与核心零部件产业链合作发展论坛
演讲地址:
14号馆馆内会议室
演讲时间:
9月10日 15:15—15:35
演讲嘉宾:
华工激光行业总监 肖冲
演讲主题:
《先进激光技术助力SiC功率半导体新发展》
9月10-12日
与华工激光相约SEMI-e现场
共同感受精密智造激光浪潮!

关于华工激光
华工激光是中国激光工业化应用的开创者、引领者,全球激光加工解决方案权威提供商。我们全面布局激光智能装备、量测与自动化产线、智慧工厂建设,为智能制造提供整体解决方案。
我们深刻把握制造业发展趋势,从精密微纳激光装备到超高功率激光装备,为您提供包括全功率系列的 激光切割 装备、 激光焊接 装备、 激光清洗 装备、 激光标记 装备、 激光热处理 装备、 激光3D打印 装备、 激光打孔 装备、 检测 装备、激光器及各类配套器件、 激光加工 专用装备等产品及 解决方案。